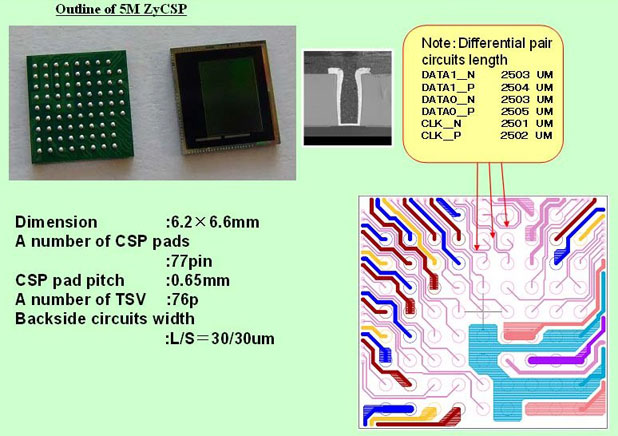
はじめに
半導体最先端製造技術の微細化は、次世代に向けて450mmウエハ、Extreme Ultra Violet(EUV)リソグラフィをはじめ従来のアプローチが引き続き進められているが、半導体市場の方からはスマートフォン、タブレットはじめグローバルなモバイル機器の活況から、先端プロセスノードでのプロセッサ半導体生産が前倒しで立ち上げが求められる状況となっている。
大容量、高性能化、低電力化に向けては、従来のプロセス・デバイス技術が引っ張っていく一方、小型化、システム化に対しては3次元半導体、すなわちThrough Silicon Via(貫通電極。以下、TSVと表記)、3D-IC、シリコンインタポーザをはじめとする技術を駆使する重みがますます高まってきている現状である。

表1 3-D Packaging Industry Article Counts
モバイル機器のカメラモジュールでのCMOSイメージセンサにTSV技術を適用する流れがここ数年volumeゾーンのビジネスとして展開されている。TSVに加えて3D-IC、シリコンインタポーザ技術などを用いてSiP(System in Package)化を図り、市場をリードするチャンピオン性能・製品を打ち上げるもう一つの展開軸がこのところ活発化してきている。
端的に、以下のキーワードをもとに業界記事に注目している。
3D:3-D IC:TSV:TSV Interposer:2.5D:Silicon Interposer
2010年からこれらのキーワードがタイトル及び概要部分に入る記事の件数が、現時点まで表1の通りである。特に昨年後半以降の増加、活況ぶりが見て取れる状況である。
当社は、2004年後半から技術開発、2006年から2007年の技術ライセンス、2008年以降の広範な3次元関連試作対応と、ビジネスのステップを踏んで重ねてきている。 本稿では、当社から見た最新の技術動向及びデータをまず概観した後、多彩な取り組みの軸が見られる3次元半導体の業界動向アップデートをまとめた。
ザイキューブの3次元半導体技術及び技術動向
1.小型化のイメージ
SVが効果をその発揮して最初にビジネスとして現れたのは携帯機器カメラモジュール用CMOSイメージセンサであるが、当社のZyCSPTSV技術を適用した小型化は、図1のような効果イメージである。
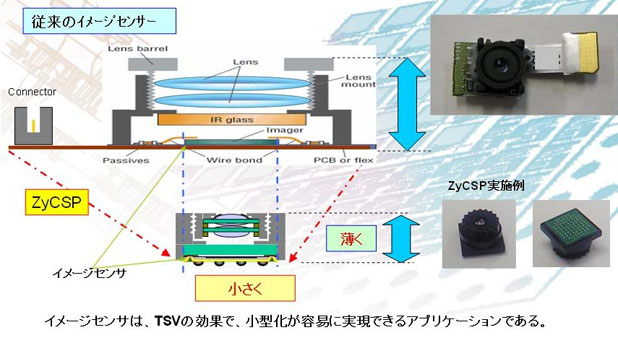
図1 ZyCSP(イメージセンサ)TSV技術の適用例
2.TSV穴あけ加工方法
3次元半導体業界のTSV穴あけ加工方法をまとめると、表2の通りである。

表2 穴あけ加工方法

表3 絶縁膜の成膜方法
- 会社名
- (株)ザイキューブ
- 所在地

-
真空リフロー、N2リフロー、エアリフローのことなら、エイテックテクトロン(株)にお任せください。フラックスレス真空リフロー装置販売開始!エイテックテクトロン株式会社
-
独自の加工技術とノウハウで様々な材料にチャレンジ 〜色々なアイデアを生み出して研究者をサポート〜 ムソー工業株式会社 代表取締役 尾針 徹治 氏Gichoビジネスコミュニケーションズ株式会社
-
話題のGlass PKG実装技術の動向 〜先端電子部品への応用と 最新のCuダイレクトめっきGWCについて〜 Grand Joint Technology Ltd 大西 哲也(T. Onishi)Gichoビジネスコミュニケーションズ株式会社














