
⑤プリント配線板の技術ロードマップ
TPCA Show2023の展示会で展示の多くは材料関係と製造設備関係のオンパレードの感じを受けた。
会場の正面入口の入った所に構えたプリント配線板メーカーのユニマイクロンの展示方法は、プリント配線板などの応用例を展示するのではなく、分野ごとの2025年度までの技術ロードマップを紹介していた点に特徴があった。技術ロードマップは写真12に示すようにパネルで展示されていた。「現在、できたプリント配線板」を展示するのではなく、「これからできるプリント配線板」の技術ロードマップを提示する方式であった。
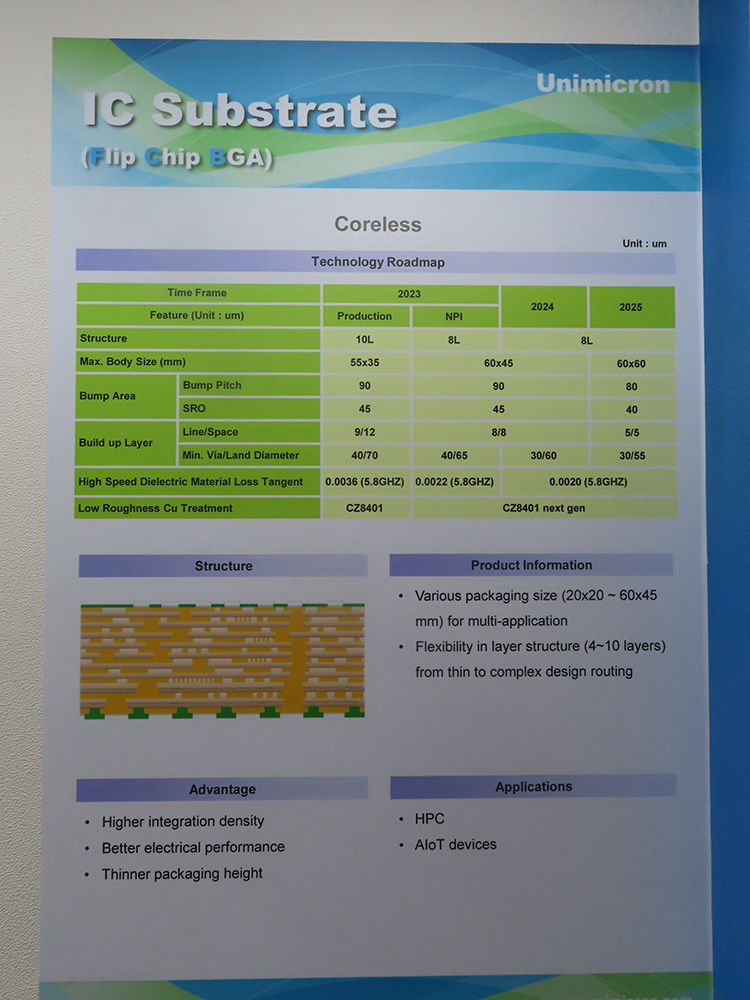
写真12 技術ロードマップの紹介したパネルの一例
では、その具体的な2025年までの技術ロードマップについて分野別に紹介する。
1. 高多層プリント配線の技術ロードマップ
高多層分野としてサーバ分野などの用途を考えると比較的大きなサイズが想定されるためか、610×812mmサイズのプリント配線板を想定しており、80層まで2025年まで達成する目標としている。アスペクト比は45までを目標にしている。それだけ穴径が小さくなり、板厚が厚くなることを意味する(表4)。

表4 高多層プリント配線の技術ロードマップ
2. ビルドアップ多層プリント配線板の技術ロードマップ
高速伝送を想定してか仕様の中に誘電正接(Df)を規定している(表5)。

表5 ビルドアップ多層プリント配線板の技術ロードマップ
3. パッケージ基板(コアレス)(FC-BGA)の技術ロードマップ
パッケージ基板なので高精細の回路形成が必要で、L/S=5/5μmが2025年の目標となっている。いろんなプリント配線板が存在する中で、パッケージ基板の分野で最も高精細のプリント配線板が進展した(表6)。

表6 パッケージ基板(コアレス)(FC-BGA)の技術ロードマップ
4. 回路埋め込みパッケージ基板の技術ロードマップ
回路のL/Sは5/5μmを目標にした高精細回路で、しかもその回路は埋め込まれたタイプとなっている(表7)。
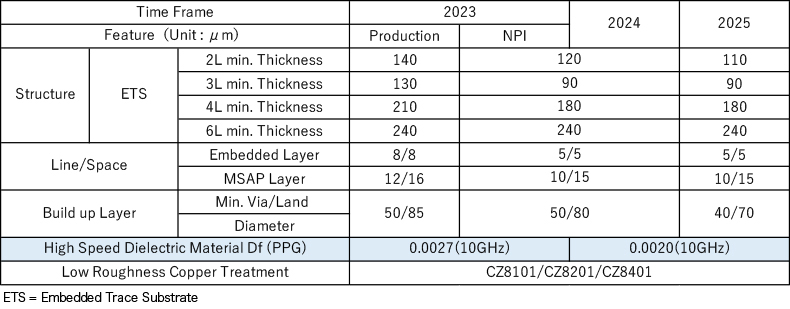
表7 回路埋め込みパッケージ基板の技術ロードマップ
5. TCA/HTCA技術ロードマップ
層間絶縁層にABFを使用したタイプでThin Core ABFとHybrid Thin Core ABFの技術ロードマップについて2025年までの目標値を掲げている(表8)。
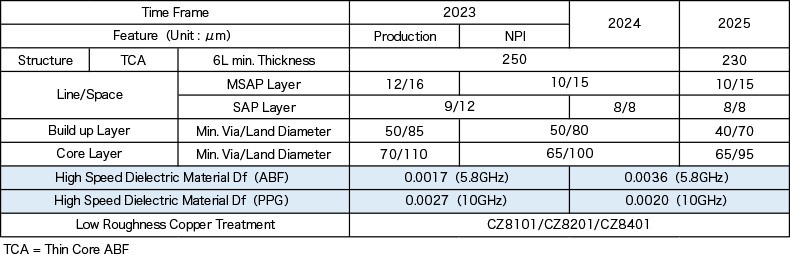
表8 TCA/HTCA技術ロードマップ
6. 部品内蔵基板の技術ロードマップ
製品サイズは小さいもののビルドアップ層は9〜11段となってコア層よりビルドアップ層の方が多くなってきている(表9)。

表9 部品内蔵基板の技術ロードマップ
7. パネルRDLインタポーザ技術ロードマップ
インタポーザの再配線層(RDL)をパネルサイズで生産する方式で、試作段階、サンプル出荷、少量生産などを明示している(表10)。

表10 パネルRDLインタポーザ技術ロードマップ
8. フレキシブルプリント配線板の技術ロードマップ
フレキシブルプリント配線板に使用される材料に進化がみられる(表11)。

表11 フレキシブルプリント配線板の技術ロードマップ
9. フレックスリジッドプリント配線板の技術ロードマップ
フレックスリジットプリント配線板に使用されるプリプレグのガラスクロスは薄いタイプが使用される(表12)。

表12 フレックスリジッドプリント配線板の技術ロードマップ
- 会社名
- 特定非営利活動法人 日本環境技術推進機構
- 所在地

-
真空リフロー、N2リフロー、エアリフローのことなら、エイテックテクトロン(株)にお任せください。フラックスレス真空リフロー装置販売開始!エイテックテクトロン株式会社
-
独自の加工技術とノウハウで様々な材料にチャレンジ 〜色々なアイデアを生み出して研究者をサポート〜 ムソー工業株式会社 代表取締役 尾針 徹治 氏Gichoビジネスコミュニケーションズ株式会社
-
話題のGlass PKG実装技術の動向 〜先端電子部品への応用と 最新のCuダイレクトめっきGWCについて〜 Grand Joint Technology Ltd 大西 哲也(T. Onishi)Gichoビジネスコミュニケーションズ株式会社














