
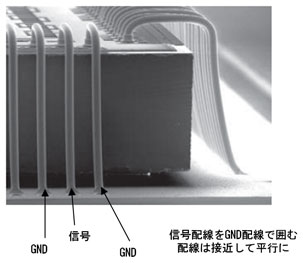
図10 ボンディングワイヤのインピーダンス制御(写真はSPT社資料より、コメントは筆者)
しかし、同じ積層でもワイヤボンディング接続では、細くて長い配線を介し、各チップが結ばれます。しかもワイヤは伝送線路としてみても、インピーダンスの制御が困難です(図10)。長く不安定な伝送線路で信号を伝えるためには、電流を多く流し、終端で波形を整える必要があります。

図11 Hynix社の8層積層メモリ(Server Memory Forum 2012)
大電力を使って、品質の悪い信号を伝達します。
たとえば、韓国Hynix Semiconductor社はDDR3メモリチップを8層積層した場合、TSVではワイヤボンディングに比べ動作速度の50%向上、消費電を40%削減が達成できたと2011年3月に発表しました(図11)。
3.TSVの実用化
まだ、学会発表や試作段階のTSVではありますが、TSVがまったく市場に出ていないかというと、そうではありません。
東芝やソニーでは、CMOSイメージセンサと論理ICをTSV接続した商品を量産しています(図12)。
また、FPGAではAltera社とXilinx社がTVSを使った2.5次元実装が製品化しています(図13、図14)。
IBM社とMicron Technology社がHMC(Hybrid Memory Cube)(図15)を発表し、現在はSamsung社やHP社、ARM社などとコンソーシアムを作成しています。
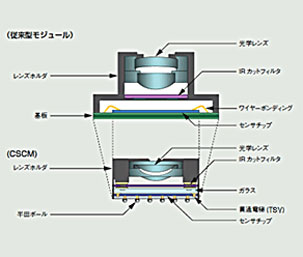
図12 TSVを使ったイメージセンサカメラモジュールの構造イメージ(岩手東芝エレクトロニクス http://www.toshiba-iwashiba.co.jp/product/cscm.htm#TSV )
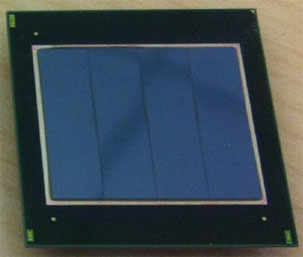
図13 Xilinx社の2.5次元実装FPGA
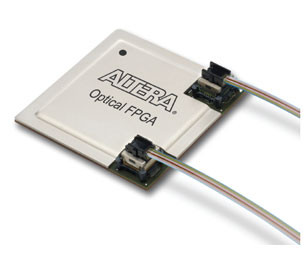
図14 Altera社の2.5次元実装FPGA
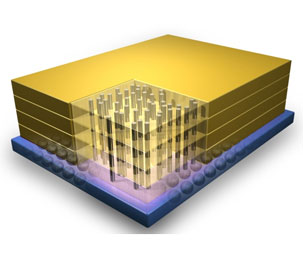
図15 HMC(Hybrid Memory Cube)
このように一部は実用化されてきたTSVですが、まだメインストリーム製品への本格的な商品化はされていません。
今年1月のネプコンセミナーでIntel社と米Qualcomm社は講演においてTSVを使ったチップの3次元実装が2015?2016年に実用化される、としていました。
このスケジュールだと、今年、2013年から来年前半にかけてはTVSは各社、量産と検査、評価技術が確立される時期にあたります。
米国各社は、このような技術のめどが立っていることに基づき、2015?2016年に実用化を発表していると思われます。
- 会社名
- (株)日本サーキット|KEI Systems
- 所在地

-
真空リフロー、N2リフロー、エアリフローのことなら、エイテックテクトロン(株)にお任せください。フラックスレス真空リフロー装置販売開始!エイテックテクトロン株式会社
-
独自の加工技術とノウハウで様々な材料にチャレンジ 〜色々なアイデアを生み出して研究者をサポート〜 ムソー工業株式会社 代表取締役 尾針 徹治 氏Gichoビジネスコミュニケーションズ株式会社
-
話題のGlass PKG実装技術の動向 〜先端電子部品への応用と 最新のCuダイレクトめっきGWCについて〜 Grand Joint Technology Ltd 大西 哲也(T. Onishi)Gichoビジネスコミュニケーションズ株式会社














