
インプラント材料は大きく、金属・高分子・セラミックの三種類がある。一般に金属は強度・靭性が高く機械加工しやすいが、導電しやすく腐食しやすいため通常はコーティングが必要であり、そのまま封止材としては用いられにくい。高分子はパリレンなど実用化されているものもあるが、無機材料に比べると経年で不安定である。セラミックは耐食性・耐熱性・絶縁性・経時での安定性に優れており硬度が高く、かつ次項で述べるALD技術のように、ナノレベルの成膜が可能であるため、インプラントデバイス封止材として有望視されている。
3. ALD技術概要
ALD(Atomic Layer Deposition)法は原子層堆積法と訳され、気相での反応で成膜をするプロセスである点は蒸着やCVDと同様だが、以下の点で他の成膜方法に比べて大きなメリットがある。
① 膜質が化学量論比に近く非常に緻密であり、ピンホールフ リー
② 素地への密着性が高い
③ 複雑な3D形状物やナノスケール表面(高ARトレンチ・ボ イド・ステップ)へも均一に成膜できる
④ 再現性の高いプロセスとして膜厚を厳密にコントロールで きる
⑤ 比較的低温での成膜が可能
アルミナ(Al2O3)を例にとると、ALDの成膜工程は次のように進行する。まず成膜対象物を入れたチャンバを真空(大凡<1hPa程度)にし、一つ目の原材料(プリカーサと呼ばれる)TMA(トリメチルアルミニウム、(CH3)3Al)ガスをチャンバに導入(パルス)する。TMAは表面のOH基に解離吸着し、この時副生成物としてメタン(CH4)が発生する。次に、窒素ガスでチャンバーを排気(パージ)し、余剰のTMAと副生成物のCH4をチャンバーから除去する。続いて二つ目の原材料H2Oをチャンバーに導入することで、表面を酸化させメタンを飛ばす。最後に再度窒素ガスで排気する。この4ステップを1サイクルとカウントする(図2)。
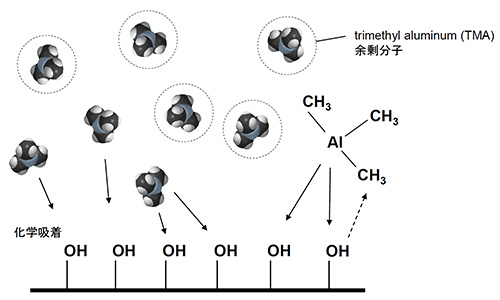
1.TMA(Trimetyl Aluminium、(CH3)3Al)分子が基板表面の-OH基と反応・吸着

2.余剰TMA分子と副生成物のメタン分子CH4を窒素ガスパージで排出

3.水分子H2OがTMA分子と反応・吸着
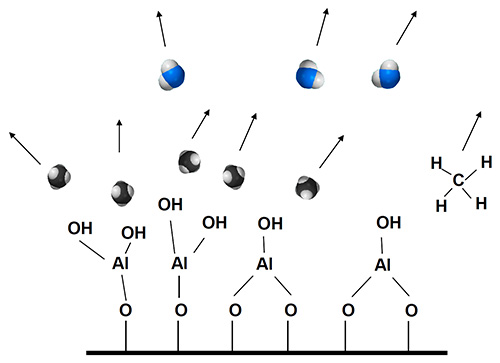
4.余剰水分子と副生成物メタン分子を窒素ガスパージで排出
図2 ALDプロセス図解
膜厚はこのALDサイクルを繰り返すことで増やすことができ、一般的には一度の成膜で数百?数千サイクルを行う。
ALD膜は対象物表面と共有結合するため密着性は非常に高い。また各パルスでは、対象物表面にプリカーサ分子が吸着できるサイトがなくなった段階で反応が終了するため、自己制御的に1サイクルで1分子層が堆積される。従って、厳密な膜厚のコントロール(1分子層≒1Å=0.1nm)が可能で、化学量論比に近い緻密な膜ができる。そのため数?数十nm程度で十分な性能を発揮できる場合も多く、デバイスを極力小型化したい場合にも有効である。理論上、十分な反応時間が確保されれば全ての表面にプリカーサ分子が吸着するため、剣山型神経電極のような高アスペクト比表面へも均一に成膜可能であり、複雑な構造物をむらなく膜封止できる。成膜温度は材料によるが、たとえばAl2O3では一般的に50℃?300℃程度であり、熱ストレスに弱い材料を使用する場合にも比較的使いやすい。
ALD法にて成膜可能な材料は、研究段階まで含めれば非常に多岐にわたるが、一般的なものとしてはAl2O3、TiO2、ZrO2などの酸化物、TiN、TaNなどの窒化物、Pt、Irなどの金属が挙げられる。半導体のhigh-k絶縁膜や拡散バリア層、MEMSの保護膜などには既に幅広く使用されており、性質上、CVDやめっきなどで性能を達成できない高アスペクト比・超薄膜アプリケーションに強みがある技術である。昨今海外では、薬剤ナノ・マイクロパーティクルをコーティングし徐放性をもたせるドラッグデリバリーシステムや、本稿で紹介するインプラントデバイスの膜封止など、バイオ・メディカル分野でのALD技術の応用が広がっている。
- 会社名
- PICOSUN JAPAN(株)
- 所在地

-
真空リフロー、N2リフロー、エアリフローのことなら、エイテックテクトロン(株)にお任せください。フラックスレス真空リフロー装置販売開始!エイテックテクトロン株式会社
-
独自の加工技術とノウハウで様々な材料にチャレンジ 〜色々なアイデアを生み出して研究者をサポート〜 ムソー工業株式会社 代表取締役 尾針 徹治 氏Gichoビジネスコミュニケーションズ株式会社
-
話題のGlass PKG実装技術の動向 〜先端電子部品への応用と 最新のCuダイレクトめっきGWCについて〜 Grand Joint Technology Ltd 大西 哲也(T. Onishi)Gichoビジネスコミュニケーションズ株式会社









.gif)






