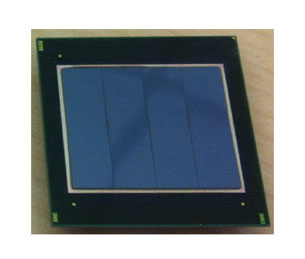
Hot Chips 24ではXilinx社がTSVを使った2.5D SiPのビジネスモデルと各社の役割分担を具体的に紹介しています(図11)。
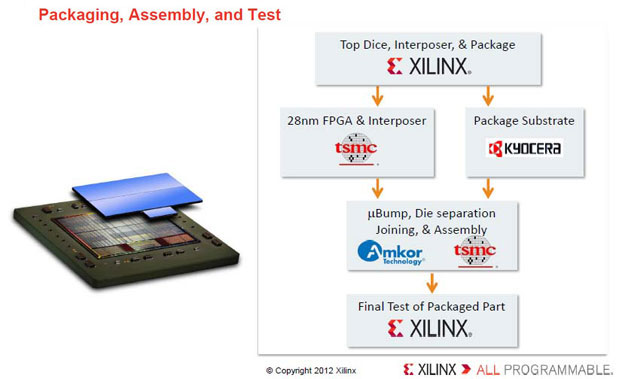
図11 TSVのサプライチェーン(Xilinx社のHot Cjips 24での発表資料より)
日本の企業の発表は技術紹介か一般論が多く、このような具体的なビジネスモデルの紹介はあまりありません。これは、日本の企業がビジネスモデルを考えずに開発をしているからではないでしょうか?
4.TSVの技術発表
表1と表2に、今年のDesignConの発表と昨年のDAC(Design Automation Conference)でTSV、2.5D、3D実装に関連した技術発表をリストしました。

表1 DesignCon 2013 TSV関連発表
 表2 DAC 2012 TSV関連発表
表2 DAC 2012 TSV関連発表
DACはIC設計のEDA(Electronic Design Automation)関連のコンベンションでLSIの設計、設計ツールの発表が主です。このため、大学からの発表も多く、アカデミックな論理的発表が多くなっています。
DesignConはDesign Conventionの意味で、システムICから基板までシステム設計に関する発表が主となっています。このためメーカーからの発表が多く、具体的な設計などの話題が多くなっています。
どちらの発表も近年は韓国や台湾などアジアからの発表が多くなっています。
残念ながら日本からの発表は大変少なく、特に大学の発表はほとんど見受けられません。
ここでも韓国や台湾のエレクトロニクス業界と日本の業界の勢いの差を感じます。また日本では大学からの発表が少なく、将来的な展望も気がかりです。
やはりDACの発表はTSVの解析モデル化や解析の手法などが多いですが、解析には電気特性と熱解析があります(図12)。

図12 TSVの熱対策(DAC*2) Exploiting die-to-die thermal coupling in 3D IC placement Georgia Institute of Technology
DesignConではやはり熱解析モデルや電気解析モデルに関する発表もありますが、製造不良解析に対する発表もあります(図13)。
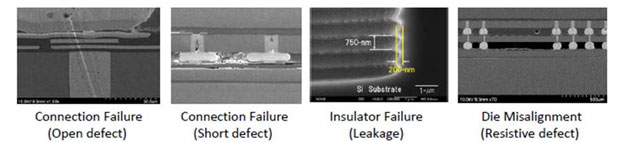
図13 TSVの不良(DesignCon *1) High-Frequency TSV Failure Detection Method with Z parameter KAIST
- 会社名
- (株)日本サーキット|KEI Systems
- 所在地

-
真空リフロー、N2リフロー、エアリフローのことなら、エイテックテクトロン(株)にお任せください。フラックスレス真空リフロー装置販売開始!エイテックテクトロン株式会社
-
独自の加工技術とノウハウで様々な材料にチャレンジ 〜色々なアイデアを生み出して研究者をサポート〜 ムソー工業株式会社 代表取締役 尾針 徹治 氏Gichoビジネスコミュニケーションズ株式会社
-
話題のGlass PKG実装技術の動向 〜先端電子部品への応用と 最新のCuダイレクトめっきGWCについて〜 Grand Joint Technology Ltd 大西 哲也(T. Onishi)Gichoビジネスコミュニケーションズ株式会社














