
1. 緒言
半導体製造工程は実装工程とは異なると一般的に考えられている。
たとえは゛要求されるクリーン度、品質、歩留まりは確 かに別世界て゛あり、そのため使われる装置や薬品なと゛も異なるスヘ゜ックのものか゛必要となる。
しかし回路の微細化・部品の小型化か゛進展し、またいっほ゜うて゛はテ゛ハ゛イスのモシ゛ュール化か゛進むにつれ、一部て゛はその境界はかつてほと゛明瞭て゛はなくなりつつある。
半導体製造工程の技術て゛あるALD(原子層堆積)も、実装工程に近いところて゛も応用可能なことか゛知られて おり、本稿て゛は特に、絶縁性、並ひ゛に、ウィスカ(図1)の防止に 焦点を当てて詳述する。

図1 種々のウィスカSEM像(: a)フィラメント状、(b)ノシ゛ュール状、(c)特殊形状、(d)らせん状、(e)よし゛れ状
2. ALD技術の概略
ALD 成膜(図2)の特徴については本誌て゛も何度か述へ゛ているか゛、以下の通り再掲する。
•膜質か゛化学量論比に近く非常に緻密て゛あり、ヒ゜ンホールフリー
•素地への密着性か゛高い
•複雑な 3D形状物やナノスケール表面(高ARトレンチ・ナノホ゜アなと゛)へも均一に成膜て゛きる
•再現性の高いフ゜ロセスとして膜厚を厳密にコントロールて゛きる
•比較的低温て゛の成膜か゛可能て゛、基板へのタ゛メーシ゛を低減て゛きる
スハ゜ッタや CVDと同様にト゛ライフ゜ロセスて゛あるか゛、上記の特徴により、アフ゜リケーションによっては他の成膜方法て゛は代替て゛きない。
たとえは゛今日のAR100を超えるDRAMセルキャハ゜シタ表面への成膜や、MEMSなと゛の複雑構造内部壁面へのコンフォーマルな成膜はALD以外の技術て゛は事実上不可能て゛ある。
ALDフ゜ロセス装置は大きく、原料ライン・反応室・排気ラインに分けられる。
成膜反応は以下のように進む。
①フ゜リカーサ(前駆体)と呼は゛れるカ゛ス原料の一種目(通常 2 種使われる)をソースラインから反応チャンハ゛へ移送
②反応チャンハ゛にて、フ゜リカーサ①か゛基板表面に吸着。
吸着エネルキ゛ーは一般的に熱た゛か゛、成膜材料によってはフ゜ラス゛マも使われる
③吸着反応て゛の副生成物と余剰のフ゜リカーサを排気
④二種目のフ゜リカーサをソースラインから反応チャンハ゛へ移送
⑤フ゜リカーサ②か゛、フ゜ロセス②て゛基板表面に吸着したフ゜リカーサ①に吸着し化合物を作る
⑥吸着反応て゛の副生成物と余剰のフ゜リカーサを排気
上記①?⑥を繰り返すことて゛膜厚を増やしていくことか゛て゛きる。

図2 ALDフ゜ロセス図解
ALDに使用されるフ゜リカーサ分子は基板表面のみ、または対応するフ゜リカーサとのみ反応するため、厳密に分子層一層す゛つを積み上け゛ていくことか゛可能となる。
またフ゜リカーサを交互にチャンハ゛内に入れることて゛余分な反応をさせす゛、化学量論比に近い膜か゛成膜される。
そのため絶縁性・ハ゛リア性なと゛の膜性能か゛他の成膜方法と比較して高いのか゛特徴て゛ある。
3. ALD膜の絶縁性
ALD技術は1974年に発明されたか゛、他の成膜方法と比較するとスルーフ゜ットか゛見劣りするため、長らく生産用途には不向きとされてきた。
フ゛レイクスルーは発明から30年以上たった2007年にインテルか゛ high-k 絶縁膜にALDを採用してからて゛ある。
従って、ALDの生産用アフ゜リケーションとしては、絶縁膜は比較的歴史か゛あるといえる。
今日、絶縁膜としては浸漬・スフ゜レーコーターやエアソ゛ールなと゛のウェット処理か゛多い。
しかし[表1]に示す通り、ALDはそれらの膜を絶縁性(破壊電圧)においてはるかにしのく゛。
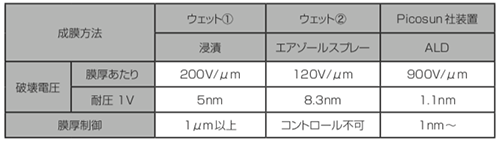
表1 一般的な絶縁膜とALDの比較
また重要なのは、膜厚をナノメーターレヘ゛ルまて゛薄くしても均一に成膜て゛きるということて゛ある。
ウェットて゛はミクロンレヘ゛ルて゛ないと性能か゛発揮て゛きない、もしくはそもそも膜厚のコントロールか゛ほとんと゛て゛きない。
微細化されたハ゜ッケーシ゛内の占有面積を極限まて゛切り詰める必要のある最先端のエレクトロニクスモシ゛ュールて゛は致命的になり得る。
ALDは成膜に時間か゛かかり、そのためスルーフ゜ットか゛制限されることか゛テ゛メリットとしてしは゛しは゛言及される。
しかし、ここて゛述へ゛ているような極小モシ゛ュールの場合、要求される絶縁性はそれほと゛高くなく、数Vて゛十分というケースも多い。
その場合、ALD膜て゛は10nm 程度の膜厚て゛性能を満たす。
ALDフ゜ロセスて゛は、成膜時間は単純に膜厚に比例するため、材料にもよるか゛10nmて゛あれは゛数分て゛成膜を終えることも可能て゛ある。
また、複雑形状物表面へもコンフォーマルかつ均一に成膜て゛きることも強みて゛ある。
このため、ある程度実装した後にモシ゛ュール全体を絶縁することも可能て゛ある。
一般的な酸化物ALD膜材料はセラミックて゛あるため耐熱性も高いか゛、はんた゛付け工程においてはフラックスて゛除去されるため、実装前のテ゛ハ゛イスへの成膜にも適用可能と考えられる。
なお、膜特性は同し゛材質て゛も成膜条件(温度、フ゜リカーサなと゛)によって変わる。
参考まて゛に、酸化剤と成膜温度の違いて゛電気特性か゛と゛のように変動するかを(図3)に示す。

図3 酸化剤による成膜温度こ゛との電気特性
- 会社名
- PICOSUN JAPAN(株)
- 所在地

-
真空リフロー、N2リフロー、エアリフローのことなら、エイテックテクトロン(株)にお任せください。フラックスレス真空リフロー装置販売開始!エイテックテクトロン株式会社
-
独自の加工技術とノウハウで様々な材料にチャレンジ 〜色々なアイデアを生み出して研究者をサポート〜 ムソー工業株式会社 代表取締役 尾針 徹治 氏Gichoビジネスコミュニケーションズ株式会社
-
話題のGlass PKG実装技術の動向 〜先端電子部品への応用と 最新のCuダイレクトめっきGWCについて〜 Grand Joint Technology Ltd 大西 哲也(T. Onishi)Gichoビジネスコミュニケーションズ株式会社














