最近のプリント配線板技術の動向
髙木技術士事務所
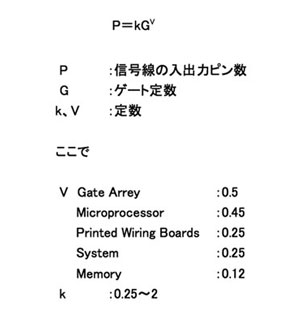
ビルドアップ法における開発技術
1.パネルめっき法とパターめっき法、セミアディティブ法
多層プリント配線板の製造プロセスのなかで、Z方向の接続と外層パターン作成法で、パネルめっき法とパターンめっき法がある。前者は工程の合理化が進み普及している。しかし高精細パターンを必要としているプリント配線板では銅箔を薄くしたパターンめっき法が次第に採用されてきている。この両者の比較を図6に示した4)。パターンめっき法はレジストの精度とシード層のエッチングによりパターン精度が決まるので、高精度になる。この方法で、銅箔を用いないものが,セミアディティブ法である。半導体チップ搭載のパッケージ基板には多く使われている方法である。しかし、樹脂基板とも接着について容易となる2µm 程度の極薄銅箔を用い、これをMSAP法という事がある。実際は銅箔を用いたパターンめっき法である。このパターンめっき法、セミアディティブ法においてはシード層のアンダーカットのない高精度のエッチングが必要である。
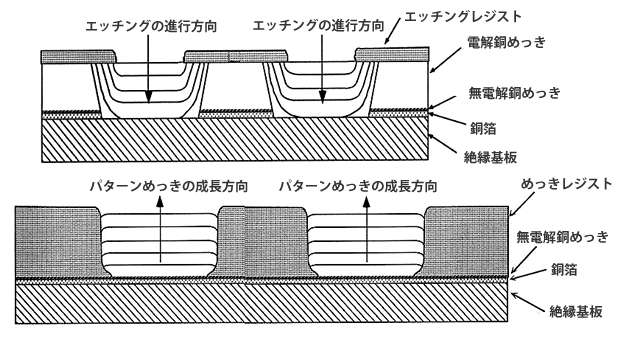
図6 パネルめっき法とパターンめっき法の比較
2.フィルドビアめっき法5)
多層プリント配線板では多数の層間の接続も必要となり、ビルドアップ法においても求められる。図7の多重層接続の形成において、従来のコンフォーマルのビアめっきでは千鳥足接続となる。ビア内をめっきで充填する事で、直上にスタックする接続とすることができ、配線の高密度化と電気特性の向上が望める。最適化するめっき液の添加剤の開発が進められ、実用化しているが、この添加剤の定常的な制御が重要となる。

図8 フィルドビアによる高密度実装の例
- 会社名
- 髙木技術士事務所
- 所在地

-
真空リフロー、N2リフロー、エアリフローのことなら、エイテックテクトロン(株)にお任せください。フラックスレス真空リフロー装置販売開始!エイテックテクトロン株式会社
-
独自の加工技術とノウハウで様々な材料にチャレンジ 〜色々なアイデアを生み出して研究者をサポート〜 ムソー工業株式会社 代表取締役 尾針 徹治 氏Gichoビジネスコミュニケーションズ株式会社
-
話題のGlass PKG実装技術の動向 〜先端電子部品への応用と 最新のCuダイレクトめっきGWCについて〜 Grand Joint Technology Ltd 大西 哲也(T. Onishi)Gichoビジネスコミュニケーションズ株式会社














