
③SicOzoneTMのメリット
オーストリア ・ ザルツブルクに本社をもつSiconnexは、バッチスプレー装置に特化したウェットプロセス(エッチング ・ レジスト剥離 ・ 洗浄)向けソリューションを提供している。同社はオゾンプロセスをSicOzoneTMというパッケージにして様々なアプリケーションに適用しており、従来のRCA洗浄から過酸化水素の代わりにオゾンを追加した洗浄プロセスや、オゾン水でのレジスト剥離プロセスに数多くの実績がある。
3-1 SicOzoneTMでのRCA洗浄置き換え
RCA洗浄はウエハ製造における標準的な洗浄プロセスであり、化学品濃度や組み合わせはラインによって異なるものの、概要は表2に示す通りである。このうちSC-1・ SC-2から過酸化水素水を除き、SC-1には代わりにオゾンを使うのがSicOzoneTM洗浄の特徴である。SC-2は希塩酸のみとなるが、過酸化水素のSC-2での役割は溶液中の貴金属がウエハに吸着することを防ぐことなので、FEOL工程で問題となることはない。ちなみに、Cuの除去はオゾン水でも可能4)であるため、Pt ・ Auのコンタミがない限りは気にする必要はないだろう。
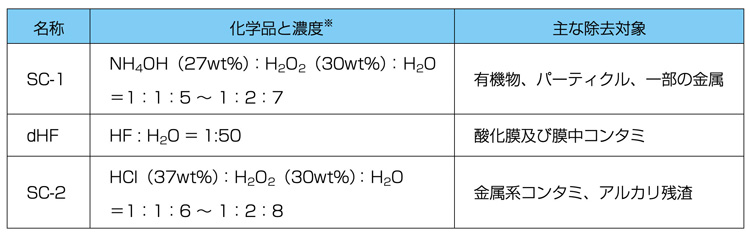
表2 RCA洗浄概要1) ※濃度にはバリエーションあり
3-2. バッチスプレーシステムとの組み合わせによるレジスト剥離
レジストのような強固なコンタミをオゾン水で除去する場合に重要なのは、オゾン水中で最も強い酸化力をもつOHラジカルである。OHラジカルは前述した通り、寿命が極めて短いため、オゾン以上にコントロールが難しい。エキシマ光を照射し、OHラジカルの生成を促進したところ、レジストの除去量はむしろ減少したという報告7)があり、これは液中のOHラジカルがレジスト表面まで移動できず、無駄にオゾンを消費しただけに終わったためと考えられる。OHラジカルを確実にレジスト表面で反応させることが、オゾン水によるレジスト剥離のキーポイントであり、オゾン水というケミカルではなく、速度論8)を踏まえた表面反応を考える必要がある。
OHラジカルは、オゾン分解の過程で一瞬だけ生成される。そのためレジストの除去に寄与するのは、レジスト最表面部に接している水中に溶解しているオゾンだけである。液体には粘度があるため、オゾン水がウエハに接触する部分には境界層が形成される(図1-a)。境界層内部では液体の流速が遅く、固液界面の最表面で基板との相対速度は理論上ゼロとなるため、装置がどのような攪拌システムをもっていたとしても、濃度勾配による拡散が境界層の外部と内部の液を置換する唯一の駆動力となる。境界層が厚く濃度勾配が小さいと(図1-b)、境界層外部から基板表面まで移動する間にOHラジカルは分解してしまいレジストと反応できない。そのため図1-cに示すように、① 境界層を可能な限り薄くすることと、② 境界層外部の濃度を可能な限り高くすることが重要である。
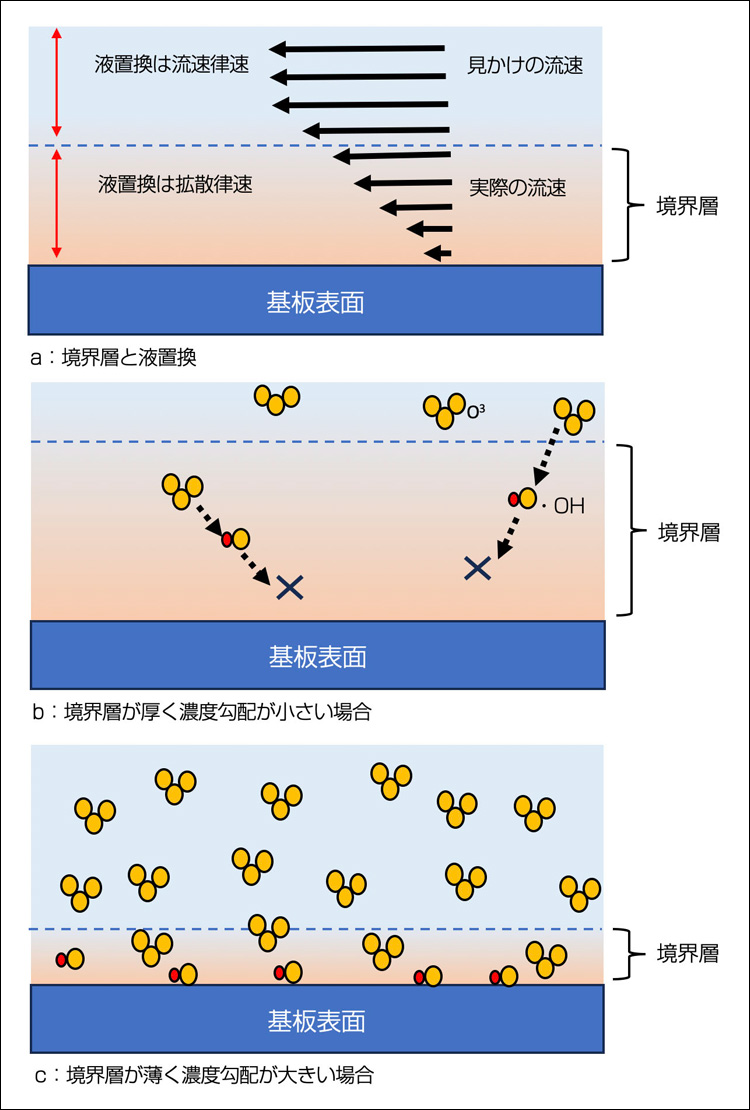
図1 境界層内部におけるOHラジカル生成概念図
まず境界層を薄くするためには、液体の粘度を下げるか、境界層外側の流速を上げる必要がある。粘度についてはケミカル特性と温度に依存するため一旦無視して、流速に着目すると、気中スプレー方式は非常に優れている。気体であれ液体であれ流体は、静止している固体表面に引っ張られて流速を落とす。この時粘度が高いほど引っ張られやすいが、気体の粘度は液体より二桁程度低いため、浸漬噴流方式と比較してはるかに流速を上げやすい。
次に境界層外部のオゾン濃度を高くするためには、新鮮なオゾン水が豊富に供給され、システムが置換され続けなくてはならない。オゾンは分解や気中への拡散で失活しやすいため、オゾン水の生成場所と使用場所は近いほど良い。高濃度オゾン水を用いる方式もあるものの、オゾンがより抜けやすいため気中スプレー方式には適さず、高濃度オゾン水の生成システムや耐オゾン材料の部品等のため、非常に特殊な仕様が必要となってしまう。SicOzoneTMでは一般的な濃度のオゾンをガスのままチャンバへ導入し、プロセス中にスプレーされている水に溶解させる。気相にオゾン分圧を確保することで液相から気相への拡散を防ぎ、かつ常に新鮮なオゾンを液中に供給することで、プロセスに適した濃度を保つことができる。
3-3. 複数ウェットプロセスの統合
2項で述べた通り、特殊なシステムを使用することでオゾンでのレジスト剥離プロセス自体は、他社でも不可能ではない。しかしSicOzoneTMの強みは、他のウェットプロセスと本質的に同じシステムを使用してレジスト剥離が可能なことである。SiconnexTMのバッチスプレー装置は、化学品を回収再利用できるタンクを最大4つ、インラインスパイキングという常に新液の化学品をかけ流しで使用するためのシステムを3つ、合計で7つ(オゾン水と合わせて8つ)のケミカルを使用することができるため、エッチングとレジスト剥離を同一装置内で連続して処理することができる。配管系統の切り替えのみで、複数プロセスを一つのチャンバで行うためフットプリントも非常に小さい(1150×1925mm)。例えば、とあるファブでは、ウエハ上にバリア膜・導電膜・フォトレジストが積み重なっている表面構造に対して、従来は導電膜のウェットエッチング後ウエハをドライ装置へ移動させ、バリア膜をドライエッチング、レジストをアッシングして、ポストアッシング洗浄のため再びウェット装置へ移動させるという工程があった。これを2種類のエッチャントを順次使用し、さらにオゾン水でレジスト剥離することで、ウエハを移動させずにSiconnexバッチスプレー装置内で完結できるように工程を合理化した(図2)。
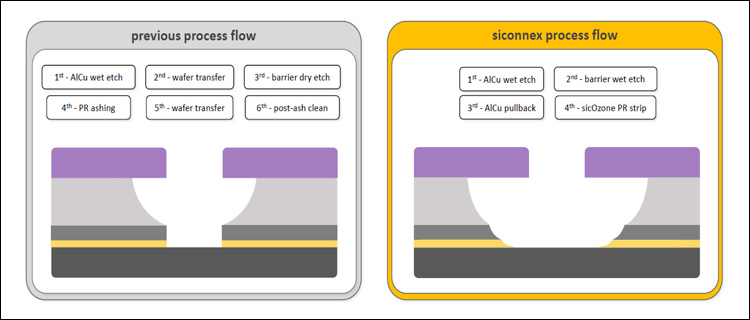
図2 SicOzoneレジスト剥離を活用したプロセスの合理化(左 : 合理化前、 右 : 合理化後)
オゾンを使用してケミカル使用量を削減することでサステナビリティに対応し、かつランニングコストを低減できることのメリットはいうまでもないが、省スペースの装置でマルチプロセスをこなす合理性のメリットも大きい。バッチ方式のためスループットも確保できることも大きな強みであり、特に少量多品種のファブ向けには魅力的な選択肢となるだろう。
3-4. 注意点
SicOzoneTMはウェットプロセスに非常にメリットのある仕組みだが、万能というわけではない。SC-2での貴金属コンタミ除去の限界については前述したが、レジスト剥離においてもすべてのレジストを完全に除去できるわけではない。ネガ型レジストの一部、及びイオン注入の加速エネルギーやドーズ量が高い場合にはオゾン水のみでは困難な場合がある。その場合には、アンモニアなど追加のケミカルを使用することで性能を強化することができる。当然のことながら、オゾン水は単純にスプレー方式であれば何でもレジスト剥離に使えるというわけではない。プロセス設計の詳細は本稿ではあえて省いてあるが、様々なパラメータを調整することになるため、諸条件を事前に確認した上でデモを実施する必要がある。従ってプロセスに実績のあるメーカーを選定する必要があることは言うまでもない。
- 会社名
- Siconnex Japan合同会社 日本市場開拓セールスマネージャー アングリア・ラスキン大学MBA ジェッセルトン大学経営管理学博士課程在籍中
- 所在地

-
真空リフロー、N2リフロー、エアリフローのことなら、エイテックテクトロン(株)にお任せください。フラックスレス真空リフロー装置販売開始!エイテックテクトロン株式会社
-
独自の加工技術とノウハウで様々な材料にチャレンジ 〜色々なアイデアを生み出して研究者をサポート〜 ムソー工業株式会社 代表取締役 尾針 徹治 氏Gichoビジネスコミュニケーションズ株式会社
-
話題のGlass PKG実装技術の動向 〜先端電子部品への応用と 最新のCuダイレクトめっきGWCについて〜 Grand Joint Technology Ltd 大西 哲也(T. Onishi)Gichoビジネスコミュニケーションズ株式会社














