
1. 全体概要
電子情報技術産業協会Jisso技術ロードマップ専門委員会では、「2019年度版 実装技術ロードマップ」を2019年6月に発刊した(図1)。

図1 2019年度版実装技術ロードマップ
ロードマップの全体構成は、
・ 第1章 総則
・ 第2章 注目される市場と電子機器群
・ 第3章 電子デバイスパッケージ
・ 第4章 電子部品
・ 第5章 プリント配線板
・ 第6章 実装設備
となっている。
本ロードマップは、個別機器、個別技術を中心に描くのではなく、グローバルな潮流の中、我が国が目指すSociety 5.0やデータ駆動型社会への変革に繋げるため、重視すべき市場/アプリケーション/ユースケースを起点に、その実現に貢献できる電子実装技術の将来動向を描くこととしている。
今後の注目すべき市場カテゴリーとして、『情報通信、メディカル・ライフサイエンス、モビリティー』に注目し、その中で重要な電子機器群を絞り込みビジネス・技術課題の抽出、解決策の提言をしている。
また新市場・新材料・新技術として『サーマルマネジメント、次世代ディスプレイ マイクロLED、次世代通信5G』を取り上げた。
2. 注目される市場と電子機器群
1.電子機器群の分類と定義
2020年に向けてIoT (Internet of Things:モノのインターネット) 基盤とも期待される、高速・低遅延・大量接続が可能な第5世代移動通信システム(5G)のサービス開始が予定されている。
それに伴いビッグデータ (Big Data:大量のデジタルデータ) が取り扱われ、データは「21 世紀の石油」とも呼ばれるように、新たな価値創造のベースとしてさまざまなシーンで活用が期待されている。
一方、得られたビックデータはAI(Artificial Intelligence:人工知能) により情報処理され、例えば、自動車の自動運転における業務処理の効率化や予測精度の向上、メディカル分野においても遠隔操作による医療行為に活用することで、現実世界において新たな価値創造につなげる活動が進められている。
このような背景のもと、2019年度版の市場別カテゴリーについて2017年度版からの変更点として、メディカルをメディカル・ライフサイエンスとし、新たに情報通信を新設、モビリティー、新市場・新材料・新技術に関して解説を行った。

図2 カテゴリーの変遷
(1)情報通信
(a)データセンターサーバー、(b)IoT センサ無線モジュール、(c)モバイルデバイス、(d)VR(Virtual Reality)/AR(Augmented Reality)/MR(Mixed Reality)、(e)テレビ
(2)メディカル・ライフサイエンス
(a)手術/検査支援ロボットとセンシング、(b)ウェアラブル端末、(c)バイオセンサ、(d)脳科学とBMI (Brain Machine Interface)
(3)モビリティー
(a)安全運転支援 - 自動走行システム、(b)コネクティッド、(c)電動化
(4)新市場・新材料・新技術
(a)サーマルマネジメント、(b)次世代ディスプレイ、(c)次世代通信5G
2.情報通信
情報通信ネットワークは4G→5Gとさらなる利便性向上を遂げることが期待されている。
特に、ミリ波領域を用いるスマートフォンなどのモバイルデバイスの進化やデータセンターサーバでの高速信号処理に対応するためパッケージの進化が不可欠となる。
図3に5Gにおける28GHzおよび39GHz対応のRF FEとトランシーバー部分のパッケージ構造を示す。
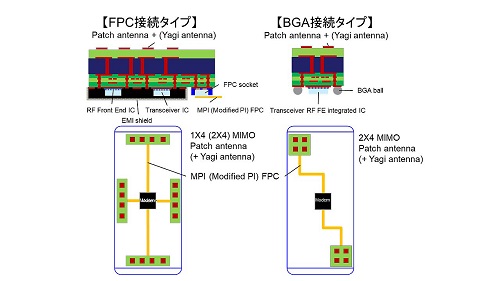
図3 AiPのタイプ(上)と複数アンテナの配置例(下)(左:FPC接続タイプ、右:BGA接続タイプ)
出典:SBRテクノロジー
RF FE部分にはSiGeが、トランシーバー部分にはCMOSが用いられるので、別々のICを搭載する必要があるが、よりコンパクトな構造においてはRF-CMOSにより統合されたICの開発が進む予想もなされている。
スマートフォンはAI(Artificial Intelligence:人工知能)端末として、また新たな情報機器端末としてAR(Augmented Reality)およびVR(Virtual Reality)機器などの普及に向けて、さらなるパッケージ性能向上の技術開発が進む。図4にスマートフォン用AP(Application Processor)パッケージ構造のロードマップに示す。
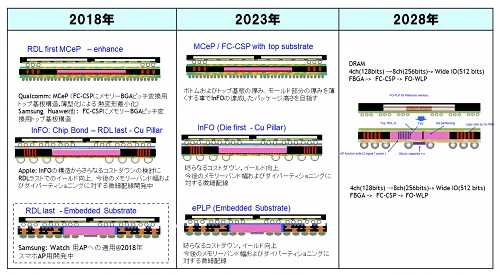
図4 スマートフォン用APパッケージ構造のロードマップ
出典:SBR テクノロジー
パッケージの低背化が可能になり、さらに電源ノイズの改善によりデータ処理性能も大幅に向上できることがInFO により証明されている。
AI化対応のために今後は他のハイエンドスマートフォン用APもコア電源品質に対してFO-WLP あるいはそれと同等なパッケージ構造を目指すことが予測される。
MCeP、InFO、ePLPの3つの構造でハイエンド領域がカバーされることが予測される。
LPDDR5の導入後さらなるバンド幅の向上のためには周波数の倍増、使用バス幅を倍の128ビット化、さらには過去議論されたWide I/O並みのバス幅の導入もいずれ必要になる。
メモリバス幅に対してRDLあるいは基板の配線ピッチは2μm/2μm(L/S)が必要となるため、その際MCePの基板では配線実現が難しくFO-WLPが必要になることが予測される。
仮にメモリがFO-WLP化されてもAPとのバス接続を銅ピラーで行うのは信号品質の観点から厳しいと想定される。
その際には、APのTSV 化が必要となるため、再度TSV 化の議論が出るかの大きな節目が2026年前後には訪れることが予測される。
メモリに関しては2015年よりLPDDR4へと、2017年にLPDDR5は間に合わずLPDDR4xとなったが、2019年よりLPDDR5の実用化への期待が高まっている。
また、図5に示すようにInFO(Integrated Fan-Out)技術が採用される方向で、パッケージの低背化が可能になり、さらに電源ノイズの改善によりデータ処理性能も大幅に向上できることが証明されている。
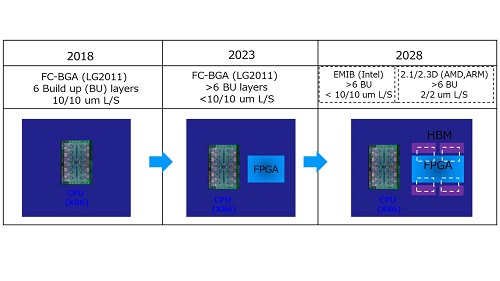
図5 HBMロードマップ
出典:SBR テクノロジー
データセンターサーバーの性能向上を加速するために、CPUと組み合わせて性能要求実現に最も大きな役割を担うAPU (Acceleration Processing Unit)の適用が進むことが予測されている。
HPC(High Performance Computing) やAI (Artificial Intelligence:人工知能)用のDeep Learning(深層学習)に対しては、GPGPU(General Purpose Graphics Processing Unit)、ASIC、FPGA(Field-Programmable Gate Array)のいずれかがAPUとして採用される見込みである。
適用アプリケーションが固定されているサーバーについては、データの前処理、後処理にFPGAをAPUとして適用する動きが進みつつある。

図6 FPGAをAPUに適用する構造例
出典:SBR テクノロジー
FPGAを使用することで電力消費を少なくでき、データ処理量が増加してもラックあたりのサーバー数を維持できることで、多くのアプリケーションに対しての性能向上が実現可能となる。
APUに使用されるメモリに関してはメモリバンド幅の大きいHBM(High Band Memory)の適用が進むことが予測される(図5)。
HBMは1サイトあたりのバンド幅は128GB/sである。
HBMが4サイトのモジュールのバンド幅は512GB/sとなる。
転送レートを2Gbpsとし、256GB/sまでバンド幅を拡大したHBM2が制定されている。
2018年になりHBM2のアップグレード仕様が制定され2.4Gbpsの転送レートで308GB/sまで性能向上を実現している。
512GB/sとさらにバンド幅を倍以上に増大させるHBM3についての仕様も議論されており、2019年中には仕様制定、2020年中の量産開始を現在目指している。
ただしバス速度は4Gbps以上となりクロストークなどシグナルインテグリティ維持が課題となる。
HBMのパッケージについては現在シリコンインターポーザを用いた2.5D 構造であるが(図7)、コストおよび高速化するバス速度に対応するために、オーガニック基板による2.1D/2.3D、EMIB (Embedded Multi-die Interconnect Bridge) 、およびFO-WLP (Fan Out Wafer Level Package) などへの推移が進む。
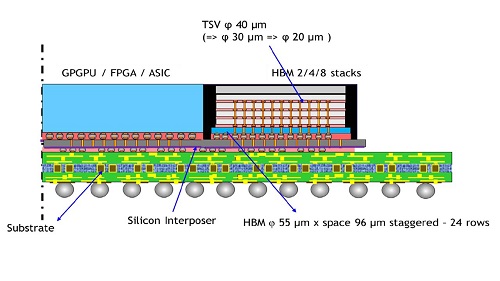
図7 2.5DによるHBMパッケージ構造
出典:SBR テクノロジー
2017年に発行されたIRDS(The International Roadmap for Devices and Systems)の半導体テクノロジーのロードマップでは2030年に1.5nmテクノロジーノードが実現する予測がされている。
EUV(Extreme Ultraviolet) 露光の導入が可能となり、少なくとも5 年はムーア則が継続される見込みとなった。
一方でChiplet という概念を用い、必要な機能を複数のダイを使用したSiP により実現する開発も進んでいる。
一例として、3D に必要なTSV(Through Silicon Via) チップは22nm テクノロジーノードを用い、先端ノードと旧世代ノードを組合せたコストパーフォーマンスの高いHI(Heterogeneous Integration)の方法も提唱されつつある。
3.メディカル・ライフサイエンス
本節では、エレクトロニクス業界から見たメディカル・ライフサイエンス領域、手術/検査支援ロボットとセンシング、ウェアラブル、バイオセンサ、脳科学とBMI (Brain Machine Interface) について解説した。
ゲノム解析/編集(図8)、癌治療/診断、認知症、虚血性心疾患、感染症に関する研究開発の最新動向をエレクトロニクスの視点で紹介、解説している。
次世代手術支援ロボット・システムの最新動向と、それに必要な生体センシング技術を紹介した。
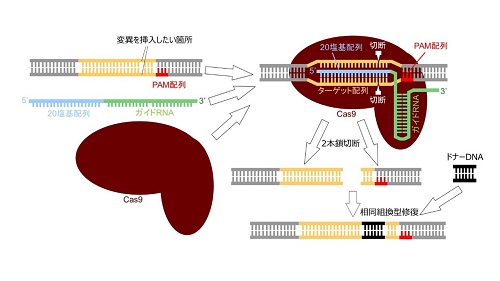
図8 CRISPR-Cas9によるゲノム編集技術
また、生体情報収集用電極、特にグラフェン電極の物性、特徴、製法や、メディカル分野での応用例 (ドラッグデリバリー、バイオセンサなど) を紹介している。
バイオセンサでキーとなるバイオ分子製造法の紹介や、バイオセンサ事例を充実、解説している。
その事例を図9に示す。
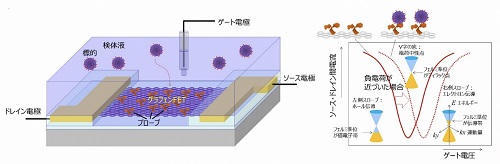
図9 高感度グラフェンバイオセンサの構造(左図)とグラフェンFETの動作原理(右図)
汎用人工知能プロセッサ開発との連携という視点での脳科学研究の動向、脳科学の応用 (脳情報通信、脳内インプラントなど) を解説している。
我々としては、エレクトロニクスとライフサイエンス分野の融合は、多くのシナジー効果を産み出し、More Moore、More than Mooreに続く第三の成長基軸となる可能性を秘め、大いに期待できる領域と考えている。
- 会社名
- Gichoビジネスコミュニケーションズ株式会社
- 所在地

-
真空リフロー、N2リフロー、エアリフローのことなら、エイテックテクトロン(株)にお任せください。フラックスレス真空リフロー装置販売開始!エイテックテクトロン株式会社
-
独自の加工技術とノウハウで様々な材料にチャレンジ 〜色々なアイデアを生み出して研究者をサポート〜 ムソー工業株式会社 代表取締役 尾針 徹治 氏Gichoビジネスコミュニケーションズ株式会社
-
話題のGlass PKG実装技術の動向 〜先端電子部品への応用と 最新のCuダイレクトめっきGWCについて〜 Grand Joint Technology Ltd 大西 哲也(T. Onishi)Gichoビジネスコミュニケーションズ株式会社














