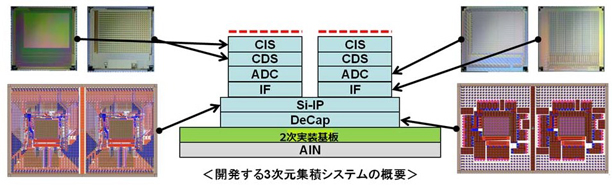
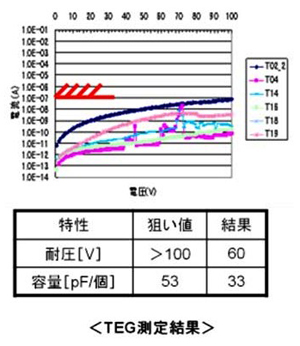
図4 TEG試作の評価結果
また、図4に耐圧評価データの一例と容量及び耐圧の評価結果を示す。キャパシタ16個並列構造のTEGの目標容量52pF・耐圧100V以上に対し、33pF・60Vを確認した。
目標値に対しやや下回ったが、これは誘電体の膜厚の最適化で調整可能な範囲であるので、この結果から、今回のSiインタポーザに70nF程度のデカップリングキャパシタを内蔵可能であることが実証できたと考え、図5に示す様に3次元画像センサモジュール用デカップリングキャパシタ及びSiインタポーザの設計とウエハ製作を行った。
設計に際しては、3次元集積システムに内蔵されるアナログ回路及びデジタル回路用の多電源回路電源インピーダンスを低周波から数GHz帯域の高周波領域までシミュレーションによる評価を行った。図6に、デカップリングキャパシタ入りSiインタポーザの電源インピーダンスのシュミュレーション結果を示す。デカップリングキャパシタあり/なしの差は歴然であり、200μmピッチと400μmピッチの高周波部分は変わらないが、400μmは低周波で共振モードが現れているため、峡ピッチTSVの効果がうかがえる結果となり、特にI/Fチップに対しては、5GHzで1.2Ω以下・共振なしという前例をみない効果をシュミュレーションで確認できた。
今後は試作の完了を待って試作チップでの効果測定を行う予定である。
具体的には、図7に示すように、車載電子機器の3次元集積化応用例のひとつである『複合センサ+アンプ+通信回路』の3次元集積チップを、自動車用運転支援画像処理システムに用い、安定的に動作させる事を目標としている。
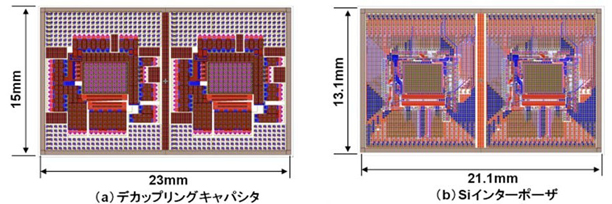
図5 3次元画像センサモジュール用デカップリングキャパシタとSiインタポーザ
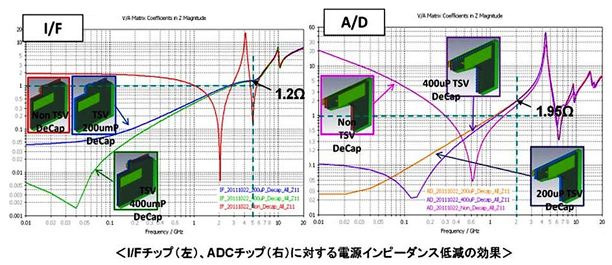
図6 電源インピーダンスのSIM結果
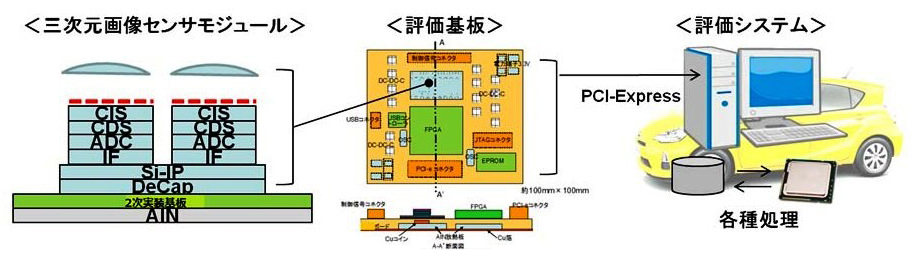
図7 自動車用運転支援画像処理システム
今後の展望とまとめ
デバイスを正しく動作させることはシステム設計者の仕事の一つであるが、見方を変えればデバイスの付加価値領域でもある。特に高周波領域での挙動をデバイス外部で制御するのは不経済であるばかりか、不可能である場合もある。多電源を干渉なく供給すること同様である。安易にデカップリングキャパシタ(パスコン)というが、ようはデバイス動作に必要な部品がすべてデバイス側に含まれているわけではないことを示しているともいえる。
応用からの要求は車載機器に限らず『ヘテロ集積』『低電力』『高信頼性』であり、これらに応えるため半導体デバイスの3次元化は進むと思われ、ヘテロ積層を利用した新機能デバイスが開発や、各種性能の飛躍的な改善が狙いとなるだろうが、そのためには、
●内部の電源環境を保障するSiインタポーザの構造・設計指針・効果が明確になる
●3次元LSIの2次実装方法の構造・設計指針・効果が明確になる
●機能実現に最適なように(ヘテロ)分割と接合を行う際の設計フローが明確になる
ことが実用化に向けての前提条件になると思われ、本研究も含め今後の成果が待たれる状況である。
謝辞
本研究は、経済産業省の『ITイノベーションプログラム』に基づき、新エネルギー・産業技術総合開発機構(NEDO)から委託された『立体構造新機能集積回路(ドリームチップ)技術開発』プロジェクトにおいて実施されたものである。
- 会社名
- 技術研究組合 超先端電子技術開発機構(ASET)
- 所在地

-
真空リフロー、N2リフロー、エアリフローのことなら、エイテックテクトロン(株)にお任せください。フラックスレス真空リフロー装置販売開始!エイテックテクトロン株式会社
-
独自の加工技術とノウハウで様々な材料にチャレンジ 〜色々なアイデアを生み出して研究者をサポート〜 ムソー工業株式会社 代表取締役 尾針 徹治 氏Gichoビジネスコミュニケーションズ株式会社
-
話題のGlass PKG実装技術の動向 〜先端電子部品への応用と 最新のCuダイレクトめっきGWCについて〜 Grand Joint Technology Ltd 大西 哲也(T. Onishi)Gichoビジネスコミュニケーションズ株式会社














