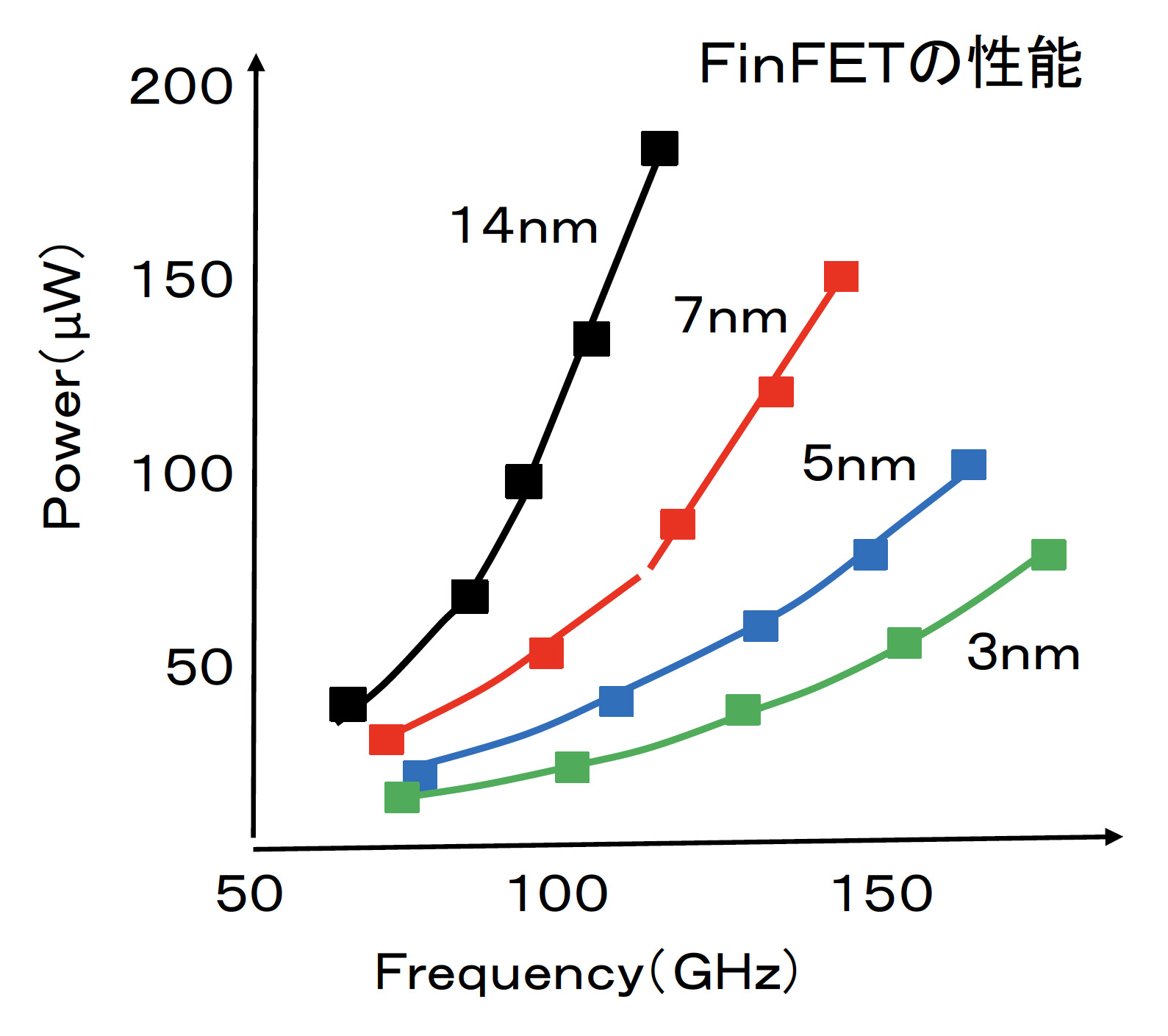
3. FinFETの採用
最初に生産されたのは、図2左のトライゲート型のFinFETであった。Finとは図3のような魚のひれのことで、バー状のSiが「ひれ」のように両側に出ていることからFinFETと名付けられた。
数年前、インテルが22nmプロセスで生産をはじめた時は、図2左のようにSiの側面と上面にゲートがあったので、Tri‐Gate(3面ゲート)と呼ばれた。
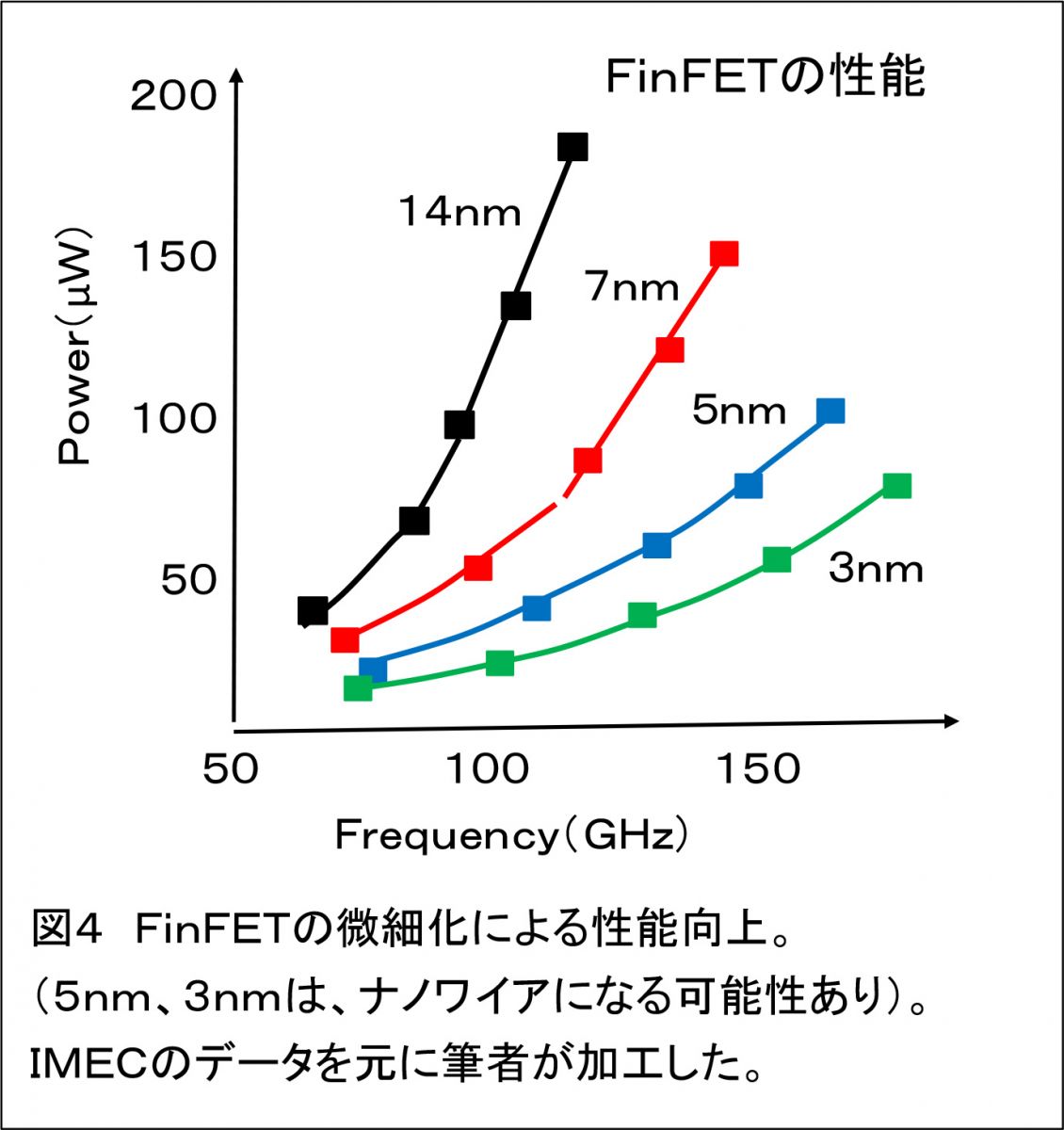
バー状のSiの3面をゲートが囲んでおり、ゲートの電界がバー全体を制御することができて、ショートチャンネル効果が抑制され、リーク電流の発生がほとんどなくなった。その後、電流を多くとる必要からSiバーはどんどん背が高くなって、図2右のようになり、Tri‐Gateというよりも、左右両面ゲート(Double Gateというべき)構造になり、通常は単にFinFETと呼ばれている。
FinFETの微細化が進むと、集積度が上がるだけでなく性能も向上する。比例縮小則に100%従うことは無理だが、消費電力と動作速度の関係は、図4のように向上する。
1. ナノワイア(GAA)へ移行か?
FinFETは、短チャネル効果によるリーク電流低減やゲート電極の制御性を高める技術を進化させたが、5nm世代ではGAA(Gate all around)への移行が検討されている(5nmでは、まだFinFETだという意見もあるが)。
GAAは、図5のように、ナノワイア状のSiチャンネルをゲート酸化膜とゲート電極がぐるりと取り囲む構造になっている。 Siナノワイアは、直径10nm以下(角型もある)が考えられているが、年々微細になると思われる。ナノワイアはゲートからの制御性は優れているが、微細なので電流が多く流せないので、図5のように数本のナノワイアを重ねた構造が考えられている。
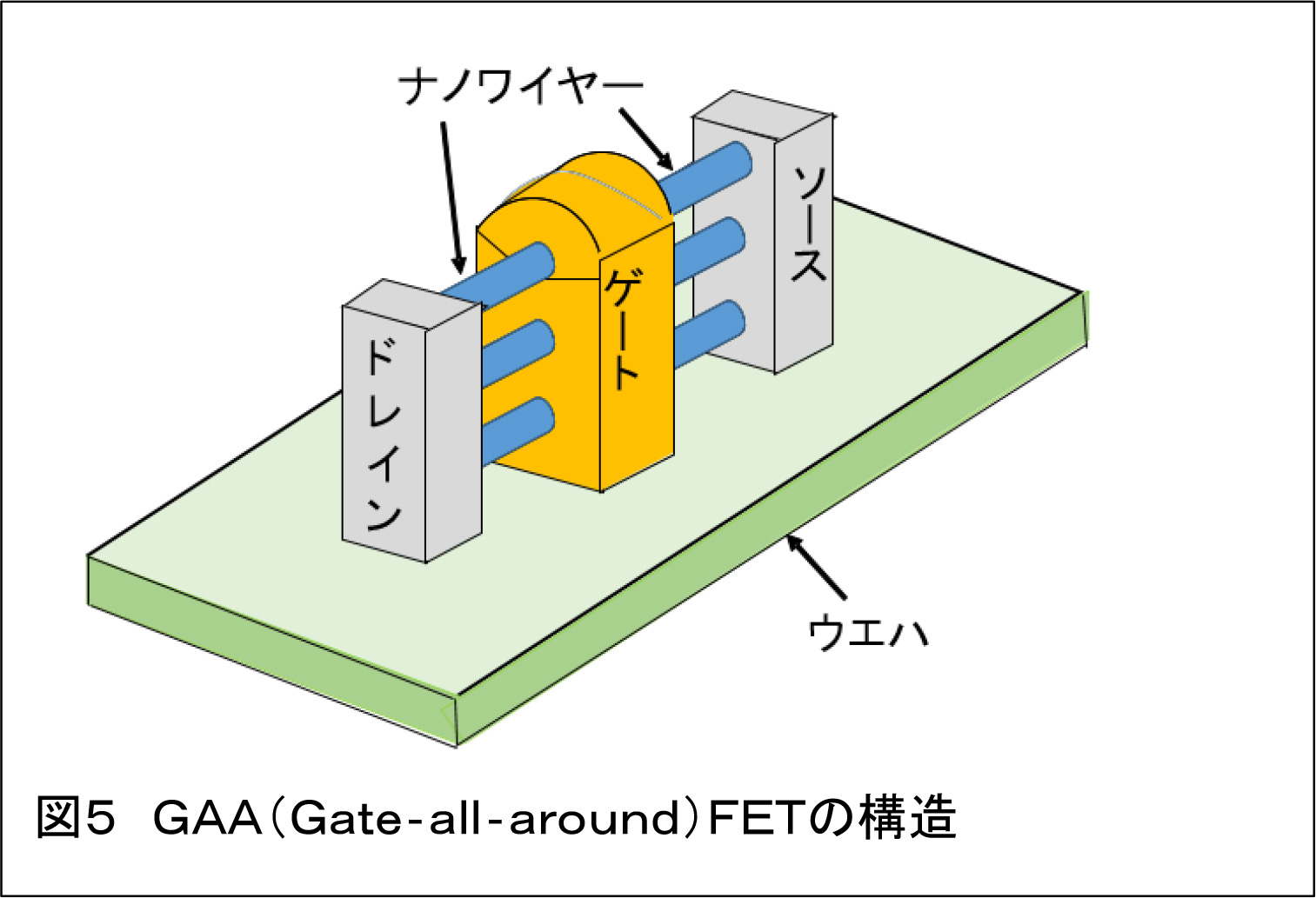
量産化を考慮すると、このようなナノワイアをウエハ上に規則正しく並べる必要があり、どんな方法でアクロバット的な構造を作るのだろうか?
レポートによると比較的簡単に書いてある。すなわち、図6のように、Si/SiGe/Si/SiGeとEpitaxial成長させ、パター二ング&エッチングしてナノワイアになる部分を壁のような構造にし、ソースとドレインの電極を設けて固定した後、SiGe層を選択的にエッチングすれば、Siワイアが残って多層のナノワイアが完成する。と、簡単に書いたが、SiGeのエッチングには、ALE(Atomic Layer Etching)という原子を1層ずつエッチングする手法が用いられ、さらにゲート酸化膜とゲート電極をナノワイアの回りに形成するには、ALD(Atomic Layer Deposition)が用いられている。まさにプロセス技術の粋を集めたデバイスの製法といえる。
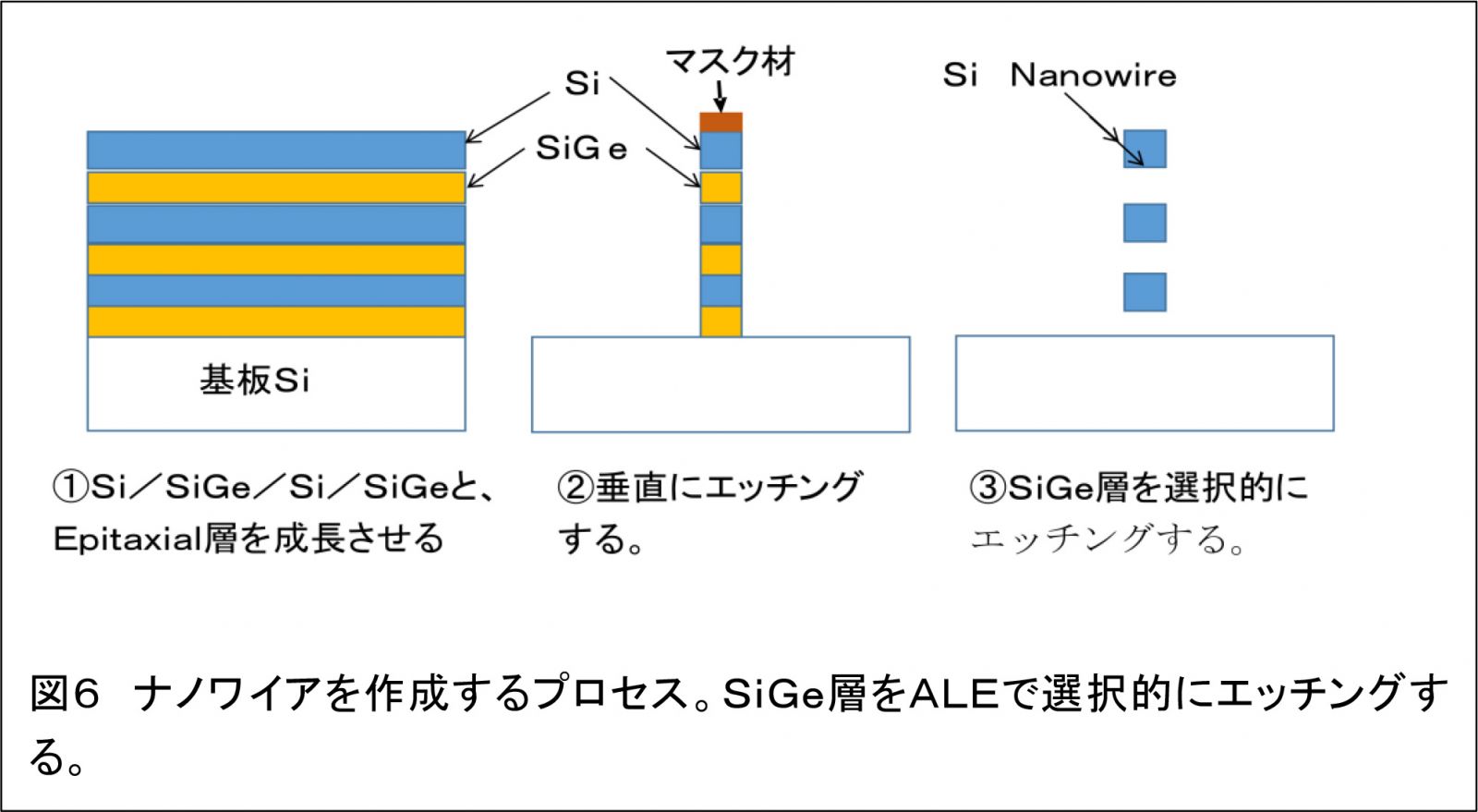
IBMのGAAに関する試作レポートによると、寸法はナノワイアのピッチが30nm、チャンネル部分の幅と高さは10nm、ゲート長は10nm、OFF状態の電流値Ioffは100nA/µm(VDD=0.68V)以下となっている。
チャンネル部分は、ドーピングなしにするとキャリアの移動度が大きくなって好ましいが、Vt(Threshold Voltage:閾値電圧)の制御が難しい。
ゲート金属の仕事関数を考慮して、PMOSとNMOSに適したゲート電極を形成すればよいが、プロセスが複雑になるので、ナノワイアを製作する時にドーピングしてVt値のアジャストを行うそうである。
2. さらにナノシートで電流値をアップ
ナノワイアと似たような構造で、ナノシートも話題になっている。ナノワイアと同じように、シートの回りをゲート絶縁膜とゲート電極が取り巻いている。ワイアよりシートの方が断面積は大きいので電流を多く流せる。ただし、トランジスタの面積はナノワイアより大きくなり、集積度は劣る。
FinFET、ナノワイア、ナノシートの断面図を図7にあげておく。ナノワイアやナノシートでは、10?5nmと微細な上に、側壁だけでなく下側(裏側)にも膜をデポジットしなければならないコンフォーマル(どんな表面にも裏面にも回り込んで膜が付着すること)が必要になるので、かなりプロセスは厄介である。しかし、数年後には量産していると考えられている。
IBMの発表によると、5nmのナノシートでは、10nmのFinFETに比べて消費電力は75%も削減できたそうで、デナードの比例縮小則は、まだ生きているようです。

3. 縦型ナノワイアへ移行するのか?
これまで見てきたナノワイアは、水平方向にナノワイアを並べる構造だったが、その先のMOS構造として縦型ナノワイア(VGAA:Vertical Gate all around)が検討されている。
図8のように、ちょうどお花の剣山か、あるいは、やまあらしの毛のように、ウエハ上に垂直にSiナノワイアが林立している構造である。
縦型ナノワイアは、数年以内に実用化されるという意見もあり、ITRS2015ロードマップでもそのように書いてあったが、水平ナノワイア時代が少なくとも数年は続くだろうから、それを飛び越して縦型がすぐに実用化されるとは考えにくく、筆者はかなり先の話だと思っている。
Siの柱を立てるだけならいろいろな方法が考えられるが、図8のようにソース・ドレイン・ゲートの電極をつけて、CMOS化のためにPMOSとNMOSを隣合わせに作るのは簡単なプロセスとは思えない。かなりの工夫が要ると思われ、今後の研究開発の進展が楽しみである。
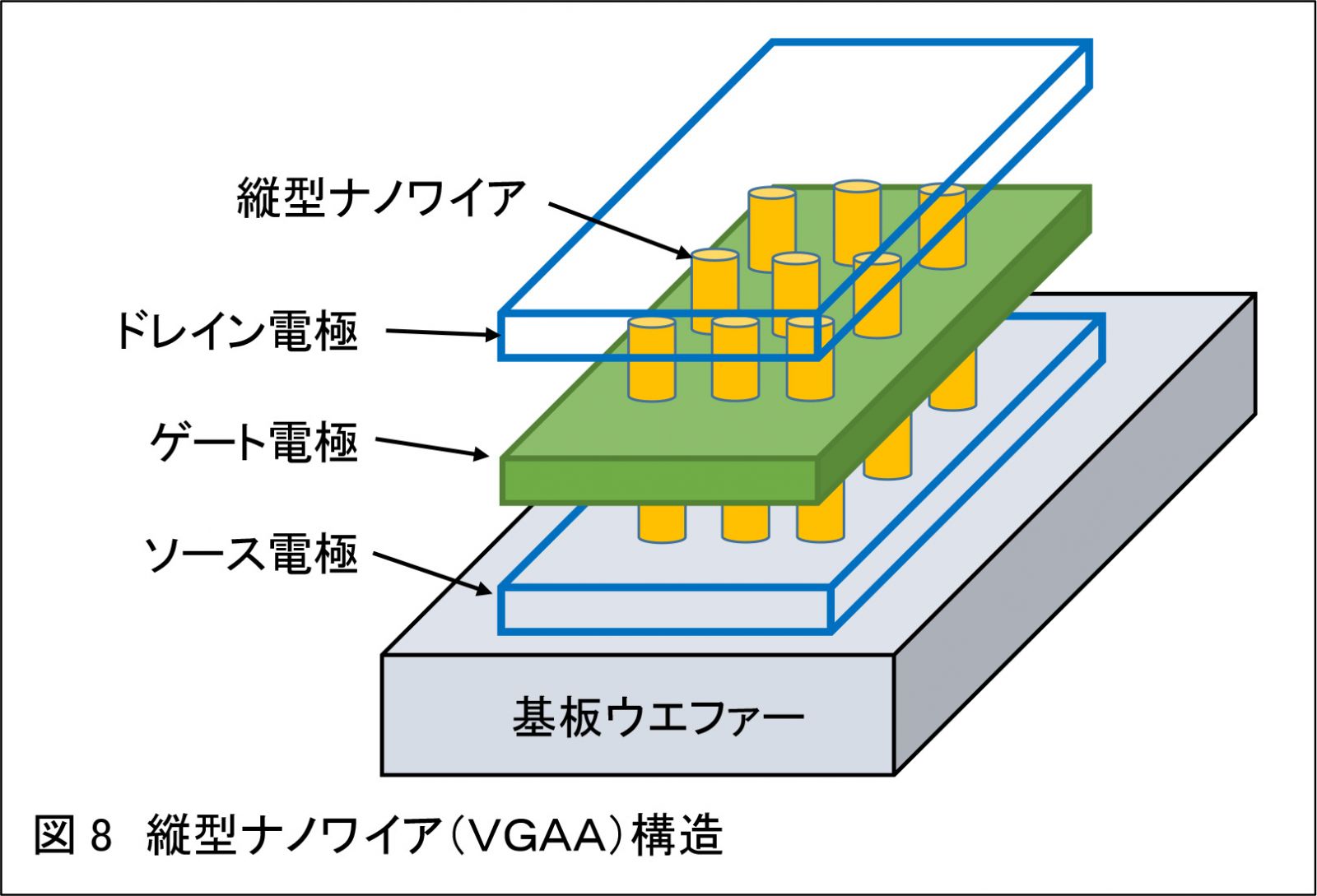
ムーアの法則は、年々LSIの集積度が向上するという意味であるが、これまでの歴史は、微細化により集積度が向上するとともに、性能も向上した。
ところが、今月述べたFinFETからナノワイヤへの進展は、集積度の向上はあまり見られず性能の向上に重点が置かれている。性能の向上のためには、異種材料の検討が精力的に行われており、来月取り上げる予定である。集積度の点だけをいえば、NANDフラッシュの3次元化に頼ることになる。
来月はムーアの法則の最終回として、それらの話題を取り上げたいと思っている。
- 会社名
- 厚木エレクトロニクス
- 所在地

-
真空リフロー、N2リフロー、エアリフローのことなら、エイテックテクトロン(株)にお任せください。フラックスレス真空リフロー装置販売開始!エイテックテクトロン株式会社
-
独自の加工技術とノウハウで様々な材料にチャレンジ 〜色々なアイデアを生み出して研究者をサポート〜 ムソー工業株式会社 代表取締役 尾針 徹治 氏Gichoビジネスコミュニケーションズ株式会社
-
話題のGlass PKG実装技術の動向 〜先端電子部品への応用と 最新のCuダイレクトめっきGWCについて〜 Grand Joint Technology Ltd 大西 哲也(T. Onishi)Gichoビジネスコミュニケーションズ株式会社









.gif)






