
2.TSVの必要性
これまでもMCM-Dやメモリチップを積層して容量を増やした製品は存在しました。
チップの積層はワイヤボンディングを使って実現できます(図3)。

図3 ボンディングを使ったチップの積層(エルピーダメモリ(http://www.elpida.com/ja/news/2007/04-23.html))
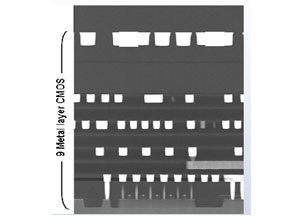
図4 ICの多層配線(9層)(Tier Logic Hot Chips 2010)
シリコンインタポーザの積層配線はIC内部の配線と同様に作成できます。現在、IC内部の配線層(メタル層)は10層以上となっています(図4)。
インタポーザにはこれほどの多層は必要ありません。シリコンインタポーザからパッケージのインタポーザへワイヤボンディングで接続すれば簡単です(図5)。

図5 TSVを使わない2.5次元実装
TSVを使用するメリットは現在、SiPの集積度向上に注目されています。
たとえば、ワイヤボンディングを使ったチップの3次元実装ではチップをずらせて積層する必要があります。また、チップにボンディングをする際にチップに力がかかるので、チップを薄くすることができず、積層すると厚くなります。さらに、ボンディングパッドの数が多くなり、パッドのエリアもインタポーザ上に広く必要となります(図6)。

図6 大きなボンディングパッド領域が必要(SPT社資料より)

図7 細くて長い配線は大きなLをもつ

図8 電源電圧変動はノイズ源
しかし、TSVにメリットはこれだけではありません。電気特性の向上に大きな意味があります。
ボンディングパッドのピッチをせかくするためにはボンディングワイヤの径は細くする必要があります。また、パッドの数の増加に従い、チップとパッドとインタポーザのパッド距離が長いものが多くなります(図7)。
細くて長いワイヤは大きなL成分をもちます。
L成分は信号の伝搬を遅らせ、波形歪みの原因となります。
たとえば、現在注目されている問題にPI(Power Integrity)があります。これは、ICの消費電力の変化によって、ICの電源電圧が変動し、信号のタイミングを変化させたり、電磁放射の原因となったりします(図8)。
この電源供給ラインに存在するL成分がICの電圧変動の原因となっています。
TSVを使用することにより、電源電圧変動(バウンス)を大幅に減少させることができます。
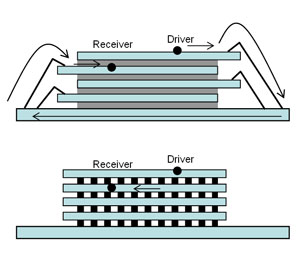
図9 TSVは配線を短くする
高速信号の伝送も同じです。たとえば複数のメモリチップをコントローラの上に積層した場合、TSVを使用すれば、コントローラと各メモリチップは最短で結ばれ、少ない電流で歪みのないデータ伝送が実現できます(図9)。
- 会社名
- (株)日本サーキット|KEI Systems
- 所在地

-
真空リフロー、N2リフロー、エアリフローのことなら、エイテックテクトロン(株)にお任せください。フラックスレス真空リフロー装置販売開始!エイテックテクトロン株式会社
-
アレムコの導電性/熱伝導性接着剤,コーティング材,グリースのことなら(株)エス・エス・アイ株式会社エス・エスアイ
-
独自の加工技術とノウハウで様々な材料にチャレンジ 〜色々なアイデアを生み出して研究者をサポート〜 ムソー工業株式会社 代表取締役 尾針 徹治 氏Gichoビジネスコミュニケーションズ株式会社
-
SEMICON Japan 2023 2023年12月13日(水)〜15日(金)の3日間、東京ビッグサイトにおいて、半導体を中心としたマイクロエレクトロニクスの製造を支える装置/材料産業の総合イベントであるSEMICON Japan 2023が開催された。Gichoビジネスコミュニケーションズ株式会社















